品牌
其他厂商性质
所在地
该设备主要用于半导体光电器件、功率器件、传感器、混合电路、微波器件及微电子机械系统(MEMS)等领域的双面对准和曝光。
主要技术特点

对准工作台
高精度薄型精密双层三维对准工作台,采用交叉滚柱V形导轨副和θ向超薄轴承及中心滑块结构,保证了工作台的直线性和旋转精度。

机械手机构
机械手采用直线导轨和滚珠丝杠结构,具有高的定位精度和重复精度。
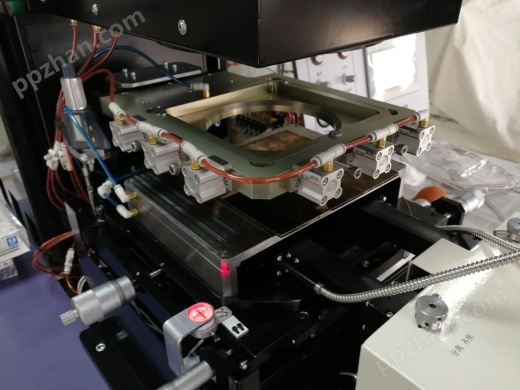
上版架系统
上掩模版的升降导轨选用THK可调分离型直线导轨,驱动采用高分辨率的数显微分头,从而保证两掩模版的重复精度和定位精度。
对准观察系统
双光路结构的卧式分离视场显微镜,可以获取高清晰的图像同时兼容CCD成像显示。
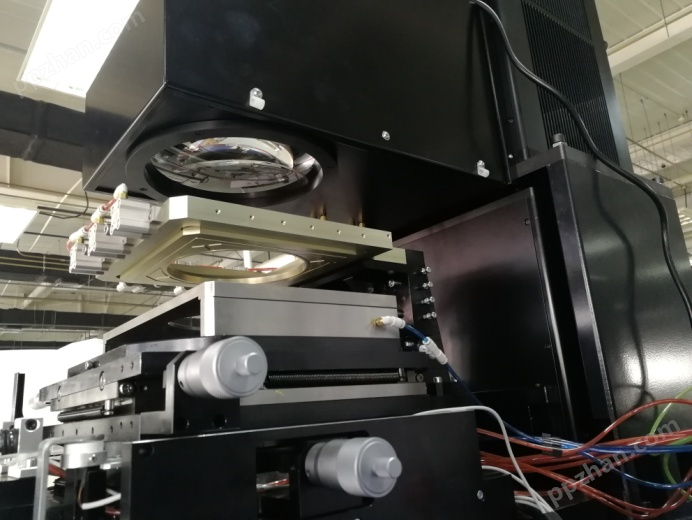
曝光系统
上、下两套独立的紫外光曝光系统,采用*的结构方案,具有较高的光强、均匀性、光学分辨率。
主要技术指标
| 性能名称 | 技术指标 | |
| 适用基片尺寸 | Max. φ4″(φ100mm) | |
| 适用掩模版尺寸 | Max. 5″(125mm×125mm) | |
| 上下掩模版对准行程 | X向 | ±4mm |
| Y向 | ±4mm | |
| θ向 | ±7.5° | |
| 上下掩模版对准精度 | ±3um | |
| 掩模版对基片对准行程 | X向 | ±4mm |
| Y向 | ±4mm | |
| θ向 | ±5° | |
| 掩模对基片对准精度 | ±3μm(以单一面两标记形位检测) | |
| 显微镜 | 物镜放大率 | 6.5× |
| 目镜放大率 | 10× | |
| 总放大倍数 | 65× | |
| 物镜分离距离 | 26~70mm | |
| 曝光光源 | 365nm,250W进口汞灯 | |
| 曝光面积 | φ110mm | |
| 曝光分辨率 | 3μm(正胶)5μm(负胶) | |
| 曝光不均匀性 | ±3% | |
| 曝光时间 | 0~999s | |
| 曝光光强 | ≥15mW/cm2 | |